半導(dǎo)體芯片封裝工藝是將裸片(或稱(chēng)為芯片)進(jìn)行封裝,以便保護(hù)芯片、提供電氣連接和機(jī)械支撐,以及方便與外部電路的連接。下面將介紹半導(dǎo)體芯片封裝的主要工藝流程,以幫助您了解這個(gè)過(guò)程。
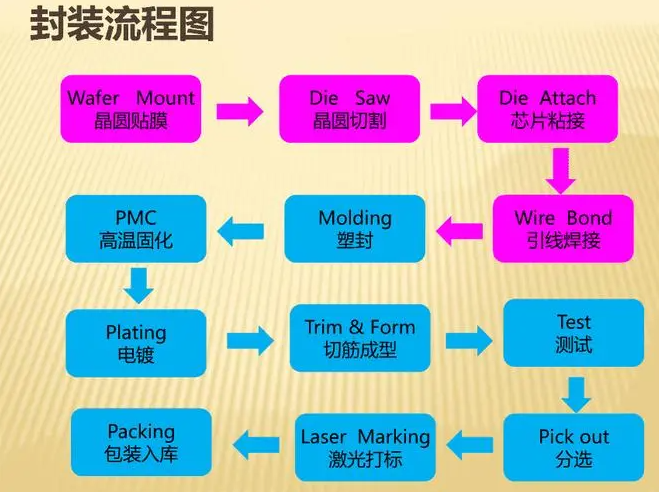
1、裸片準(zhǔn)備
首先,從半導(dǎo)體晶圓制造工藝中得到的裸片(芯片)需要經(jīng)過(guò)一系列準(zhǔn)備工作。這包括清洗裸片以去除雜質(zhì)、切割成單個(gè)芯片,并對(duì)其進(jìn)行必要的測(cè)試和排序。
2、芯片粘合
將芯片粘貼在支撐介質(zhì)上,通常使用粘合劑將芯片固定在基板上。這一步驟旨在提供機(jī)械支撐和穩(wěn)定性,以便進(jìn)行后續(xù)處理。
3、線路連接
在芯片上添加金屬線進(jìn)行電氣連接,這些金屬線用于連接芯片的電極和其他器件或引腳。通常使用微細(xì)線鍵合技術(shù),例如焊線鍵合或晶片內(nèi)鍵合,將金屬線連接到芯片的電極。
4、密封
在芯片和線路連接之后,使用封裝材料(通常是環(huán)氧樹(shù)脂)對(duì)芯片進(jìn)行封裝。密封材料包圍芯片和連接線,提供保護(hù)、機(jī)械支撐和電絕緣。封裝材料通常是通過(guò)熱固化或紫外線固化來(lái)固化和固定。
5、引腳形成
在封裝完成后,需要形成芯片的引腳,以便與外部電路連接。這可以通過(guò)切割封裝材料以暴露引腳,或使用其他技術(shù)(如針腳連接、球柵陣列等)實(shí)現(xiàn)。
6、測(cè)試和質(zhì)量控制
經(jīng)過(guò)封裝和引腳形成后,對(duì)封裝芯片進(jìn)行嚴(yán)格的測(cè)試和質(zhì)量控制,以確保其功能正常、性能穩(wěn)定和質(zhì)量可靠。這些測(cè)試可以包括電氣測(cè)試、可靠性測(cè)試和外觀檢查等。
7、成品封裝
最后,通過(guò)組裝和封裝工藝將封裝芯片與其他電子元件(如電阻、電容、晶振等)組裝在一起,形成最終的成品封裝器件。這些封裝器件通常被安裝在電路板上。
半導(dǎo)體芯片封裝工藝流程的目標(biāo)是通過(guò)封裝和連接技術(shù),將裸片轉(zhuǎn)化為可使用的封裝器件,并提供保護(hù)、穩(wěn)定性和可靠性。封裝工藝流程中的每個(gè)步驟都起著關(guān)鍵作用,確保芯片的功能性、性能和質(zhì)量達(dá)到要求。隨著技術(shù)的不斷發(fā)展,一些新型封裝技術(shù)也在不斷演進(jìn),例如宇凡微的合封芯片,更高集成度和高可靠性、還能更省成本。

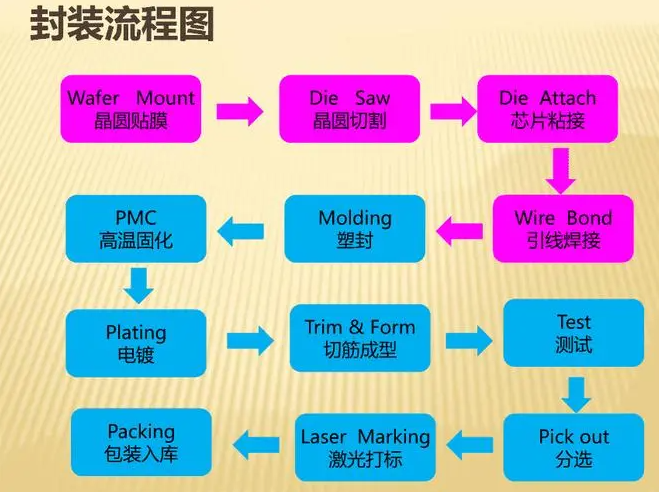
 微信二維碼
微信二維碼
 粵公網(wǎng)安備 44030402004503號(hào)
粵公網(wǎng)安備 44030402004503號(hào)